经过验证的面板加工生产性能
全球各地的生产设备
- 最大 650x650 毫米的面板
- 创新的面板尺寸解决方案,包括 310x310mm
"种子层 "工艺
- 沟槽和通孔的共形涂层
- 高深宽比工艺
下一代 集成电路基底和芯片封装
- PVD 工艺可减少碳足迹,实现更小的结构
- 双面工艺的基片翻转能力
行业领先的生产解决方案
- 除气、蚀刻和 PVD 工艺解决方案
- 最低 Rc 和最高产量实现最佳 CoO
扇出型面板级封装和先进封装基板
新型神经网络,如 ChatGPT 和其他生成式AI,以及各种人工智能 (AI) 应用,正在推动对高性能计算 (HPC) 的需求达到前所未有的水平。Chiplet-封装、新型散热方法、微型化、新型材料集成以及功率优化等创新技术都显示了先进封装在这些进步中的重要作用。
先进封装技术具有高采用率和显著的技术优势,是一个快速增长的细分市场,为支持行业路线图提供了一条途径。
从 310x310mm 到 650x650mm,面板级封装的创新与机遇
溅射种子层正在取代化学种子层,带来一系列新的可能性。下一代封装基板和类基板PCB的原始设备制造商OEM和制造商都在采用溅射种子层技术,以实现更小、更精确的结构,提高可靠性并减少制造过程中的碳足迹。将新材料(如玻璃芯和玻璃通孔 (TGV))集成到封装中,以及开发下一代 Chiplet-封装 将带来令人兴奋的机遇。
将越来越多的芯片集成到一个封装中会增大这些封装的尺寸。随着封装尺寸的增大,圆形晶片上的材料和设备利用率变得很低。因此,该行业正在转向面板尺寸的半导体级工艺设备,这种设备可处理和加工尺寸从 300x300mm 到 600x600mm 不等的矩形基板。
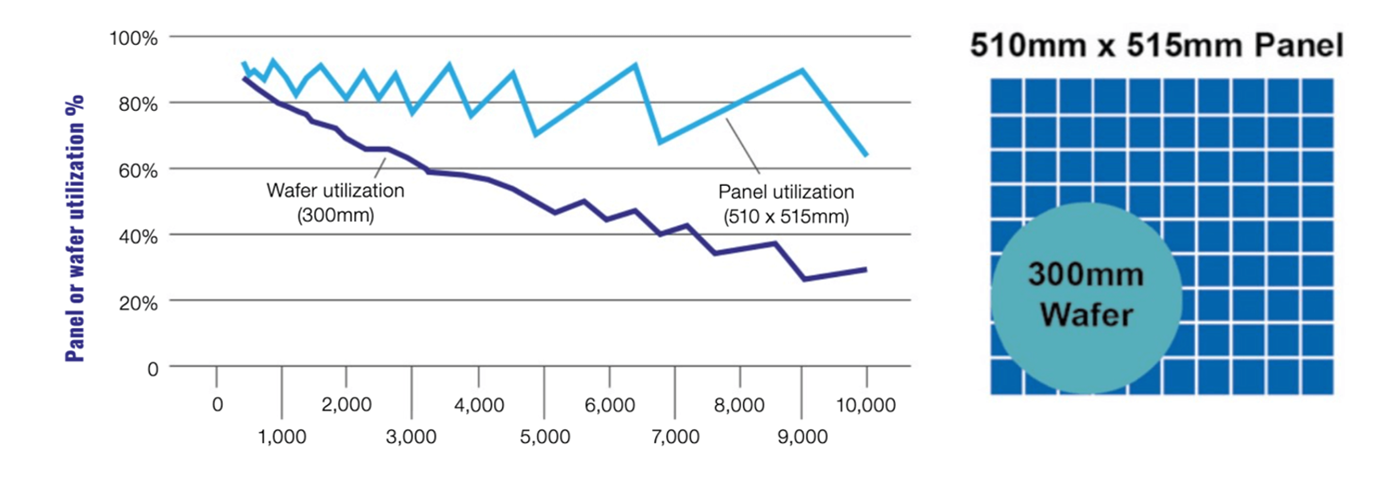
Evatec 是面板级半导体工艺设备的市场领导者,其工艺设备适用于FOPLP封装和先进封装基板,可使用多种材料。Evatec 市场领先的 CLUSTERLINE® 600 平台可加工最大尺寸为 650x650mm 的基板,在除气、种子层附着力和叠层均匀性方面具有一流的性能。
产品机台
Evatec 面板级封装设备组合
根据您的基板、工艺要求、产量和工厂集成需求,从 Evatec 机台中进行选择。
我们的专家可帮助您找到适合您规格的平台。或者,点击按钮详细了解每个平台。

CLUSTERLINE® 600
市场领先的设备解决方案,用于 FOPLP 和下一代集成电路基板加工,面板尺寸可达 650x650 mm,集成了大面积脱气、蚀刻和沉积技术。
在我们的《LAYERS》杂志上阅读更多有关面板级封装的信息

更环保的印刷电路板/集成电路基板行业
了解如何通过减少原材料和湿法工艺、优化产品堆积和引入干法工艺来减少 PCB 制造业的二氧化碳排放量。

CLUSTERLINE® 600 和下一代集成电路基板
我们在 CLUSTERLINE® 600 平台上取得的最新进展突显了该平台适合为人工智能和高性能计算等新兴市场制造先进的集成电路基板。

扇出封装技术的关键挑战
Samsung Electro-Mechanics 谈及与 Evatec 合作解决扇出封装技术的挑战,以成功生产 Samsung GALAXY 手表。
