Choose Plasmabox for pinhole free, high purity films and simple reactor maintenance
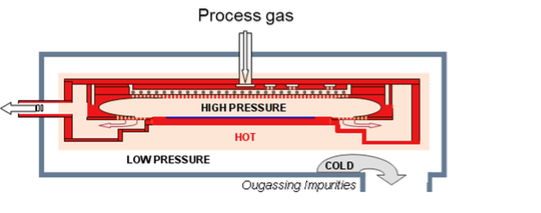
From the smallest to the biggest- get an idea how many substrates our systems can hold in a single batch


エッチング技術
ウェーハまたはパネルレベルでのアプリケーション向け技術
均一で高速度での独立したエッチングプロセスは、別の課題を提起しますが、追加のプラズマエッチング処理セットによって成膜された膜の特性をさらに改善することができます。 エバテックは、金属または誘電体のエッチング、膜の緻密化、自然酸素除去、後酸化、アッシング、およびスパッタリングの幅広い分野で、それぞれ専用のプロセス経験と組み合わせたカスタムソース設計を提供します。すべてのエバテックのソリューションには、スループットを最大化し、コストオブオーナーシップを最小化するという1つの共通の目標があります。
誘電体エッチング
膜の密着力は、表面処理の開始時に重要な役割を果たします。特に、ポリマーに光学フィルターなどの機能性コーティングを成膜する場合、エバテックのバッチプロセスモジュール技術を搭載したCLUSTERLINE®200とMSPでの表面の活性化と自然酸素の除去が最適な結果への道を開きます。また、実際の成膜プロセス中に補助プラズマエッチング手法を使用して、最良の金属酸化物成膜が得られます。 CCPソースでプラズマビームを生成し、制御された量のイオンエネルギーでこのビームを成長中の膜に適用すると、優れた密度、段差被覆性/ギャップ充填、および表面粗さが得られます。他の技術では、同じレベルの質や量が達成できません。この技術は、光バンドパスフィルター、温度補償弾性表面波(SAW)フィルター、およびその他の多くのアプリケーションに使用される多層スタックの大量生産に最適なソリューションの基礎となります。
金属エッチング
イオンビームエッチングは、BAKプラットフォームでの蒸着アプリケーションに最適な方法です。
先端パッケージング
CLUSTERLINE®300およびHEXAGONプラットフォームで利用可能な専用のICP Arctic Etchテクノロジーは、高イオンフラックス用のICPと、調整可能なイオンエネルギー用のRF基板バイアスを組み合わせて使用します。ハイブリッドリアクターは、脱ガスおよびスパッタリング技術と組み合わせることで、FOWLPなどの一般的なアプリケーションにおいてガス放出の多い有機基板上で安定した接触抵抗(Rc)値を実現します。さらに大面積の基板表面もエッチングする必要がある場合は、エバテックのCLUSTERLINE®600で使用されているデュアル周波数CCPをご使用ください。プラットフォームは、物理的および化学的エッチングプロセスを推進し、ファンアウトおよびIC基板の生産をパネルレベルのスケールで実現します。
エバテックのノウハウとプラットフォームの詳細については、個々のタブをクリックするか、ここをクリックしてお問い合わせください。
誘導結合プラズマ技術
エバテックの ICPテクノロジーを選択して、次の機能を活用してください
- 良好なプラズマの誘導結合を得るために最適化されたリアクター設計と駆動周波数により、非常に高いプラズマ密度でまた非常に再現性のあるプロセスが行われます
- 高イオン電流の衝撃エネルギーを調整するためのRF基板バイアスにより、物理的および化学的エッチングプロセスで非常に高いレートが可能になります
- 物理的イオンエッチングは化学的エッチングと混合でき、調整可能な空間分布を備え、ウェーハの中心から端までマスクを介して選択的にエッチングすることができます。
- クリーンなプロセスのために慎重に開発されたウェーハ環境は、最先端のパーティクル性能につながります
容量結合プラズマ技術
次の機能を利用するには、エバテックのCCPテクノロジーを選択してください
- 容量結合プラズマ源は、豊富な経験に基づいた信頼性の高いエッチングソリューションを提供する、確立された薄膜エッチング技術です。
- 最新のモデルには、特別に選択された単一または二重周波数RF供給システムが装備されており、連続モードまたはパルスモードで動作し、最も困難なアプリケーションでも最適なパフォーマンスのエッチングプロセスを提供します。
- イオンエネルギーとイオンフラックスの幅広い範囲の制御用に設計されたハードウェアは、要求の変化に合わせてエッチングステップを調整することにより、将来の要求に備えることができます
- 磁気または幾何学的な「プラズマ成形」の組み込みオプションにより、エッチング速度と均一性レベルの両方が同時にパーセンテージ範囲に保たれ、望ましいコスト効率をもたらす高い歩留まりと長い稼働時間を提供する堅実なソリューションとして機能します。
- 低電圧で高エネルギーの準中性プラズマビームによる表面処理により、ウェーハ上の敏感な層またはデバイスへのチャージアップが最小限に抑えられます。
ETCHプラットフォーム
エバテックの各プラットフォームには、先端パッケージング、半導体、オプトエレクトロニクス、およびフォトニクスマーケットのニーズに合わせて調整された特定のリアクター設計が備わっています。プラズマエッチング機能を備えた薄膜成膜のソリューションを補完することで、薄膜処理ソリューションの完全な組み合わを備えた強力な装置になります。
エバテックの専門家が、適切なプラットフォームを見つけるお手伝いをします。写真のリンクをクリックして、各プラットフォームの詳細をご覧ください。
BAKファミリー
柔軟なボックスコーターの大きさは0.5〜2.0メートルで、手動または自動ロードにより、蒸発前、蒸発中、蒸発後のエネルギー衝撃および物理的エッチング用のさまざまなイオンビーム源を提供します。
CLUSTERLINE®200
誘電体と金属の選択的で損傷のないエッチングを行うためのRFバイアスを備えたICPを可能にする独立したプロセスモジュール。 CCPが成長中の独立したエッチングプロセスまたはフィルム処理を可能にするバッチプロセスモジュール。
CLUSTERLINE®300
シングルプロセスモジュールを備えた300mmクラスタープラットフォームにより、RFバイアスを使用したICPエッチングが可能になり、誘電体、透明導電膜、および金属を高速で選択的に高均一性で損傷のないエッチングが可能になります。
CLUSTERLINE®600
FOPLPおよび最大650x650mmのパネルサイズの次世代IC基板処理用のツール。デュアル周波数CCPソースを統合して、スパッタリングプロセスの前に高速で均一なエッチングを実現します。
HEXAGON
FOWLPのような高度なパッケージングアプリケーション専用のプラットフォームで、スパッタリング成膜の前に大量にガス放出する有機基板を準備するためのRFバイアスを備えたICP Arcticエッチングを提供します。
LLS EVO II
大きなバッチの基板を同時にエッチングするためのCCPテクノロジーを搭載した手動またはロボット搬送機能を備えた半導体アプリケーション用の垂直バッチスパッタリングプラットフォーム。
均一で高速度での独立したエッチングプロセスは、別の課題を提起しますが、追加のプラズマエッチング処理セットによって成膜された膜の特性をさらに改善することができます。 エバテックは、金属または誘電体のエッチング、膜の緻密化、自然酸素除去、後酸化、アッシング、およびスパッタリングの幅広い分野で、それぞれ専用のプロセス経験と組み合わせたカスタムソース設計を提供します。すべてのエバテックのソリューションには、スループットを最大化し、コストオブオーナーシップを最小化するという1つの共通の目標があります。
誘電体エッチング
膜の密着力は、表面処理の開始時に重要な役割を果たします。特に、ポリマーに光学フィルターなどの機能性コーティングを成膜する場合、エバテックのバッチプロセスモジュール技術を搭載したCLUSTERLINE®200とMSPでの表面の活性化と自然酸素の除去が最適な結果への道を開きます。また、実際の成膜プロセス中に補助プラズマエッチング手法を使用して、最良の金属酸化物成膜が得られます。 CCPソースでプラズマビームを生成し、制御された量のイオンエネルギーでこのビームを成長中の膜に適用すると、優れた密度、段差被覆性/ギャップ充填、および表面粗さが得られます。他の技術では、同じレベルの質や量が達成できません。この技術は、光バンドパスフィルター、温度補償弾性表面波(SAW)フィルター、およびその他の多くのアプリケーションに使用される多層スタックの大量生産に最適なソリューションの基礎となります。
金属エッチング
イオンビームエッチングは、BAKプラットフォームでの蒸着アプリケーションに最適な方法です。
先端パッケージング
CLUSTERLINE®300およびHEXAGONプラットフォームで利用可能な専用のICP Arctic Etchテクノロジーは、高イオンフラックス用のICPと、調整可能なイオンエネルギー用のRF基板バイアスを組み合わせて使用します。ハイブリッドリアクターは、脱ガスおよびスパッタリング技術と組み合わせることで、FOWLPなどの一般的なアプリケーションにおいてガス放出の多い有機基板上で安定した接触抵抗(Rc)値を実現します。さらに大面積の基板表面もエッチングする必要がある場合は、エバテックのCLUSTERLINE®600で使用されているデュアル周波数CCPをご使用ください。プラットフォームは、物理的および化学的エッチングプロセスを推進し、ファンアウトおよびIC基板の生産をパネルレベルのスケールで実現します。
エバテックのノウハウとプラットフォームの詳細については、個々のタブをクリックするか、ここをクリックしてお問い合わせください。
誘導結合プラズマ技術
エバテックの ICPテクノロジーを選択して、次の機能を活用してください
- 良好なプラズマの誘導結合を得るために最適化されたリアクター設計と駆動周波数により、非常に高いプラズマ密度でまた非常に再現性のあるプロセスが行われます
- 高イオン電流の衝撃エネルギーを調整するためのRF基板バイアスにより、物理的および化学的エッチングプロセスで非常に高いレートが可能になります
- 物理的イオンエッチングは化学的エッチングと混合でき、調整可能な空間分布を備え、ウェーハの中心から端までマスクを介して選択的にエッチングすることができます。
- クリーンなプロセスのために慎重に開発されたウェーハ環境は、最先端のパーティクル性能につながります
容量結合プラズマ技術
次の機能を利用するには、エバテックのCCPテクノロジーを選択してください
- 容量結合プラズマ源は、豊富な経験に基づいた信頼性の高いエッチングソリューションを提供する、確立された薄膜エッチング技術です。
- 最新のモデルには、特別に選択された単一または二重周波数RF供給システムが装備されており、連続モードまたはパルスモードで動作し、最も困難なアプリケーションでも最適なパフォーマンスのエッチングプロセスを提供します。
- イオンエネルギーとイオンフラックスの幅広い範囲の制御用に設計されたハードウェアは、要求の変化に合わせてエッチングステップを調整することにより、将来の要求に備えることができます
- 磁気または幾何学的な「プラズマ成形」の組み込みオプションにより、エッチング速度と均一性レベルの両方が同時にパーセンテージ範囲に保たれ、望ましいコスト効率をもたらす高い歩留まりと長い稼働時間を提供する堅実なソリューションとして機能します。
- 低電圧で高エネルギーの準中性プラズマビームによる表面処理により、ウェーハ上の敏感な層またはデバイスへのチャージアップが最小限に抑えられます。
ETCHプラットフォーム
エバテックの各プラットフォームには、先端パッケージング、半導体、オプトエレクトロニクス、およびフォトニクスマーケットのニーズに合わせて調整された特定のリアクター設計が備わっています。プラズマエッチング機能を備えた薄膜成膜のソリューションを補完することで、薄膜処理ソリューションの完全な組み合わを備えた強力な装置になります。
エバテックの専門家が、適切なプラットフォームを見つけるお手伝いをします。写真のリンクをクリックして、各プラットフォームの詳細をご覧ください。